01 行業背景
薄膜沉積(如CVD/ALD)是半導體制造的核心工藝之一,需定期使用NF?清潔腔室以去除沉積物。精確控制清潔終點至關重要:

傳統方法依賴經驗時間控制,但實際最佳清潔時間受沉積厚度、溫度、壓力等因素影響,且參數可能漂移。因此,多數工藝會延長清潔時間以確保徹底清潔,但造成資源浪費。
02 應用需求
Johnson等(2004)提出通過監測SiF?分壓確定清潔終點。紅外氣體傳感器因其高實時性和可靠性,已成為主流檢測手段。
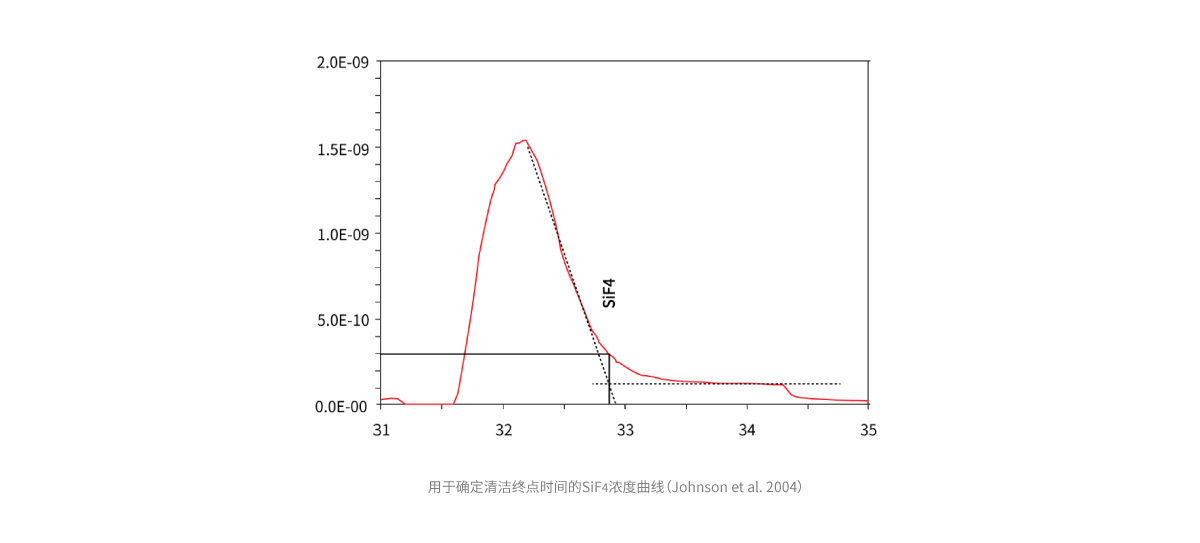
NF?與沉積物反應生成SiF?氣體,其分壓變化可反映清潔狀態:

03 解決方案
四方儀器作為國際領先的紅外氣體傳感器制造商,針對薄膜沉積設備清潔終點檢測需求,推出SiF?、WF6紅外氣體傳感器。

04 技術優勢

雙光束紅外(NDIR)技術
電調制光源+雙通道探測器,抗干擾能力強

環境適應性
參考通道補償溫濕度及交叉氣體干擾

高精度
量程0~200 mTorr,準確度≤±1.0% F.S.
響應時間T90≤2秒
紅外氣體傳感器Gasboard-2060
紅外氣體傳感器是由四方儀器自主研發的高性能氣體傳感器,產品基于非分光紅外技術(NDIR),能夠精確測量半導體等應用中產生的SiF4、CF4、SF6、NF3、CO2等氣體,兼容機臺內常見預留尺寸、法蘭和通訊協議,可用于半導體沉積和清洗工藝的端點檢測、腔室清理終端檢測,能夠減少清潔時間,節約成本,提高產量。
紅外氣體傳感器Gasboard-2061
紅外氣體傳感器是由四方儀器自主研發的高性能氣體傳感器,產品基于非分光紅外技術(NDIR),能夠精確測量半導體等應用中產生的WF6、CF4、SF6、NF3、CO2等氣體,兼容機臺內常見預留尺寸、法蘭和通訊協議,可用于半導體沉積和清洗工藝的端點檢測、腔室清理終端檢測,能夠減少清潔時間,節約成本,提高產量。
紅外氣體傳感器Gasboard-2060
紅外氣體傳感器是由四方儀器自主研發的高性能氣體傳感器,產品基于非分光紅外技術(NDIR),能夠精確測量半導體等應用中產生的SiF4、CF4、SF6、NF3、CO2等氣體,兼容機臺內常見預留尺寸、法蘭和通訊協議,可用于半導體沉積和清洗工藝的端點檢測、腔室清理終端檢測,能夠減少清潔時間,節約成本,提高產量。
主站蜘蛛池模板:
毕业论文5000字大专|
巴霍巴利王3电影免费观看|
浪客剑心星霜篇|
前线任务|
美丽的草原我的家二胡独奏|
大团圆李静张娴|
光脚踩|
自拍成人|
东方电视台节目表今日节目|
吃屎视频搞笑视频|
张艺宣|
车辆年检新规几年一审|
我和我的父辈电影免费播放完整版|
科洛弗|
我的神我要敬拜你歌谱|
在线播放啄木乌丝袜秘书|
平型关大捷纪念馆|
意大利a级情欲片女人城|
布衣神相国语电视剧在线看完整版|
帅克|
青春之旅动漫|
《可爱的小鸟》阅读答案|
骨妹|
娇妻与爱女绿帽孕野种|
局中局|
苹果广告|
奇奇颗颗说恐龙|
千面魔女|
青草视频在线观看视频|
我是传奇 电影|
叠影危情|
我的爱情撞了战争电视剧|
婴儿睡眠时间对照表|
感恩节电影恐怖片|
清白堂记|
英雄卡片简单又漂亮|
内蒙古电视台|
电影《48天》免费观看全集|
免税车中企诚谊|
王小凤|
mc水观音|



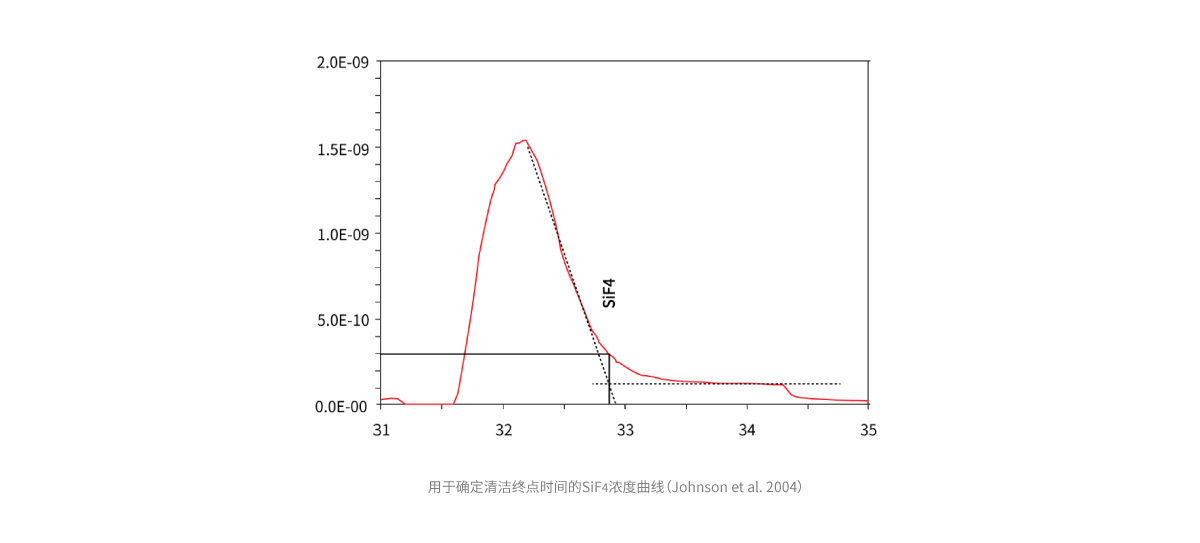


 在線
在線 咨詢
咨詢 關注
關注